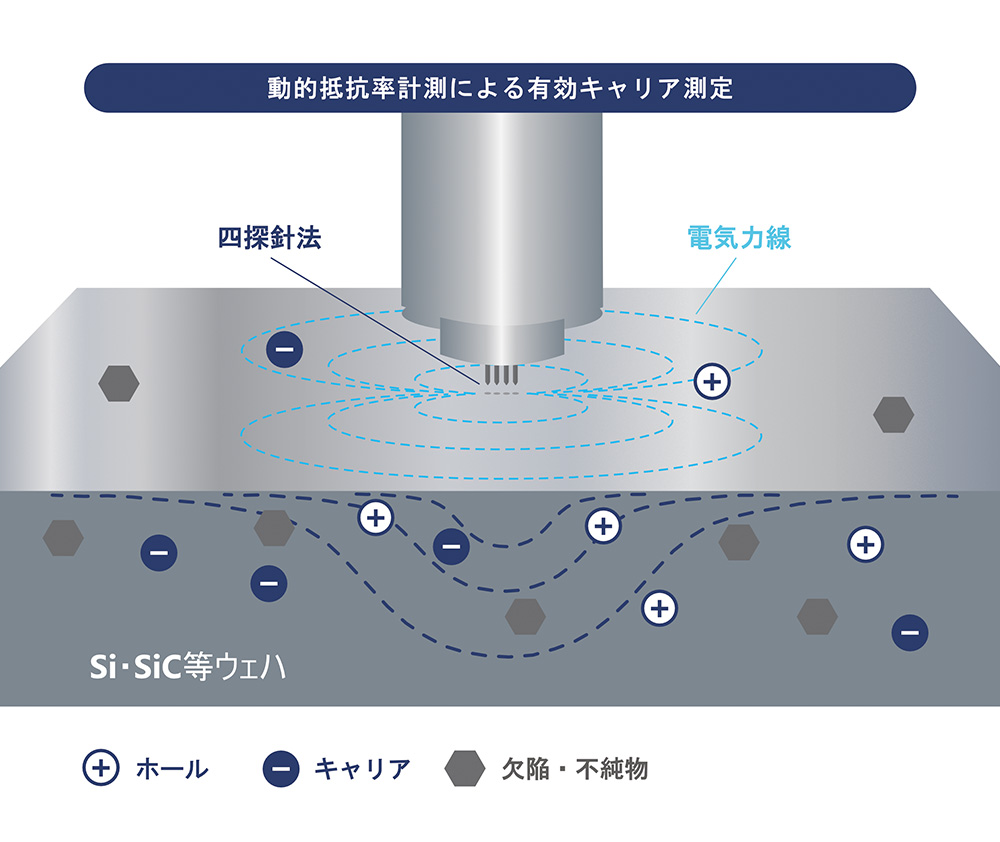
HS-CMR法(High Speed-Current Modulating Resistivity method)は、東北大学金属材料研究所での研究により、
四探針抵抗率測定法を新たな理論と統合することで生まれた新技術です。
高速で印加電流を変化させながら抵抗率プロファイルを得ることにより、
ウェハ表面の汚染や機械的ダメージだけでなく、内部の結晶欠陥や不純物による影響まで正確に反映し、
総合的にウェハの品質を評価することが可能となります。
HS-CMR法により得られたパラメーターは、デバイス化後の品質と相関があります。
測定によって得られた品質係数や抵抗率等の情報は、結晶成長技術やスライス技術、テクスチャリング・ラッピング技術などの向上に
役立てることができます。
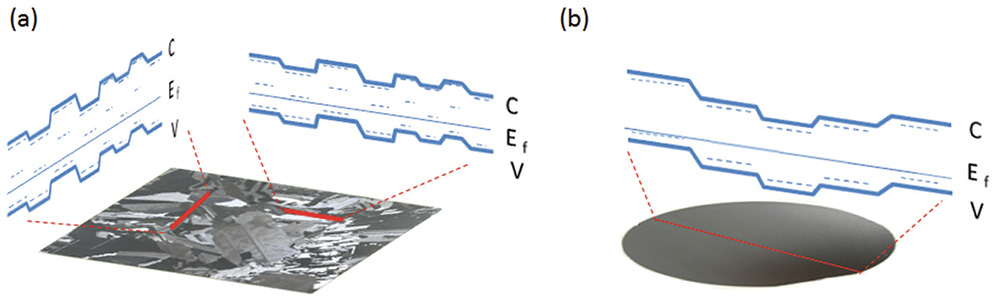
理想的な半導体ウェハの場合はどの電流値で抵抗率を測定しても同じ値を示しますが、実際の半導体ウェハには汚染、不純物、機械的ダメージ、
結晶欠陥などが存在しており、これらの影響から抵抗率の値には電流依存性が発生します。
ウェハはドーパントや不純物、結晶欠陥などの影響からpn混在となっており、
品質を正確に表すには表面と内部の状態を総合的に評価する必要があります。
HS-CMR法は試料毎に最適化された可変電流を印加し、抵抗率のプロファイルを取得・解析することによって、
ウェハ表面と内部を総合的に計測することが可能となります。
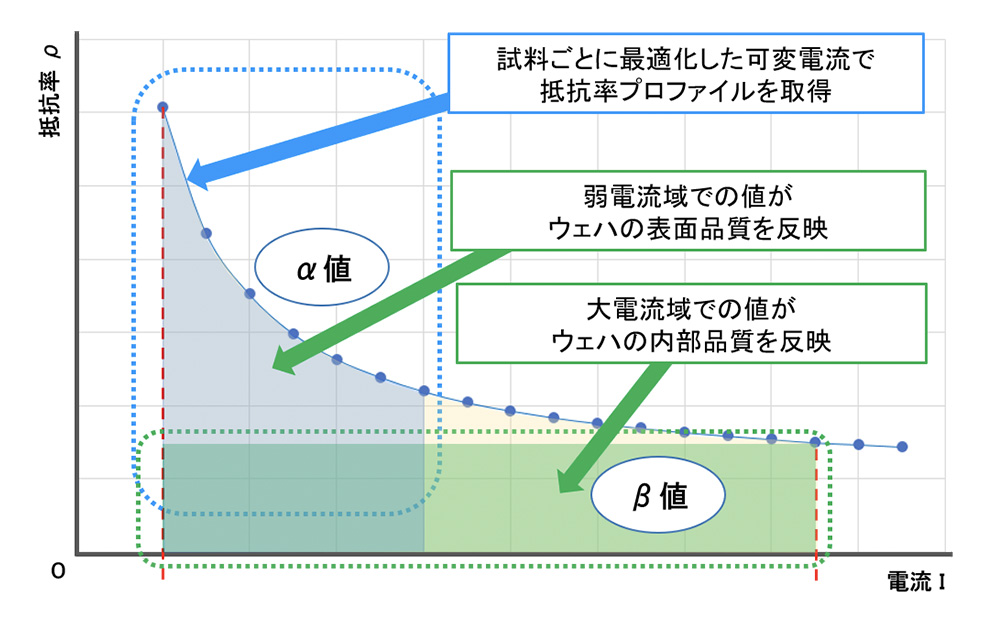
HS-CMR法では、ウェハに可変電流を印加しながら抵抗率を測定します。
すると、縦軸を抵抗率、横軸を電流値とした時、上図のような曲線を得ることができます。
この曲線を解析することで、主にα値、β値という2つの品質係数を得ることができます。
α値は主にウェハ表面の品質を反映し、β値は内部の品質を反映します。

可変電流による抵抗率のプロファイルは、ウェハの表面及び内部の結晶品質を総合的に表すことが出来ます。
測定対象のウェハが高品質である場合、電流・抵抗率プロファイルが示す曲線は、曲率が大きくなり、
特定の抵抗率まで降下した後、速やかに安定(収束)する傾向にあります。
これに対し、ウェハが低品質である場合は、電流・抵抗率プロファイルの示す曲線の曲率は小さく、
また、抵抗率もなかなか収束しません。
HS-CMR法はこれらの情報を解析しα値、β値という2つの品質係数で示すことにより、ウェハの品質を評価することができます。


測定結果につきましては、ウェハ全体の状態を把握できる電流・抵抗率プロファイルと共に、ウェハ表面の状態を主に示すα値、
ウェハ内部の状態を主に示すβ値を提供させて頂きます。また、α値、β値のカラーマッピングデータもご提供できます。